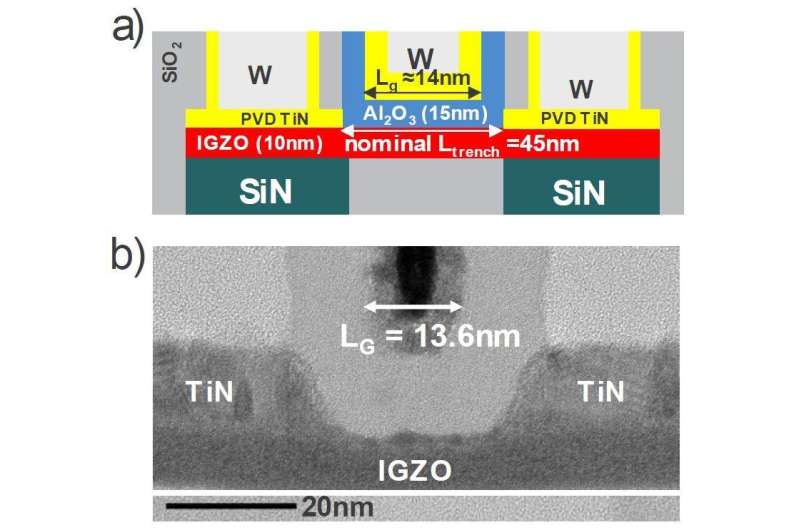
基于无电容的铟镓锌氧化物(IGZO) DRAM电池架构显示了实现高密度3D DRAM内存的巨大潜力。
在本文中,imec的内存程序主管Gouri Sankar揭示了一个基于IGZO的DRAM单元,该单元对于DRAM内存应用程序具有优秀的规范—多亏了对IGZO晶体管架构的优化。此外,他还展示了基于对IGZO薄膜晶体管可靠性的新见解,对DRAM电池关键组件的第一次寿命估计。
研究结果发表在2021年IEEE国际电子器件会议(IEDM)上的两篇论文中。
向着高密度3D DRAM发展
在去年的国际电子器件会议(2020 IEDM)上,imec首次展示了一种无电容动态随机存取存储器(DRAM)电池,实现了两个铟镓锌氧化物(IGZO)薄膜晶体管(TFTs)和无电容。这种新型的2-晶体管-0-电容(2T0C) DRAM单元结构承诺克服经典的1-晶体管-1-电容(1T1C) DRAM密度缩放的关键障碍,即小单元尺寸的Si晶体管的大电流,以及存储电容消耗的大面积。在2T0C IGZO-TFT DRAM单元中,不需要存储电容,因为读晶体管的寄生电容充当存储元件。此外,igzo - tft以其极低的非电流而闻名,从而增强了记忆细胞的保留能力。最后,在后端行(BEOL)中处理igzo - tft的能力允许减少DRAM内存的占用(通过在内存阵列下移动内存单元)并堆叠单个DRAM单元——因此提供了通往高密度3D DRAM的道路。要继续为数据密集型应用程序(如人工智能、物联网、数据中心和云计算)提供足够的DRAM容量,就需要这种演变。
2020年,第一个具有>400s保留时间的2T0C igzo基DRAM单元可能被演示,这导致与经典DRAM变种相比,刷新率和功耗显著降低。该器件在300mm的晶圆上制造,栅极长度缩小到45nm。然而,在第一次“概念性”演示中,IGZO tft并没有被优化为最大保留,而且对耐久性的评估(即故障前的读/写周期数)仍然缺失。而且,当时还没有准确的模型来预测IGZO的寿命。
>103S保持,无限的耐久性和栅极长度可扩展至14nm
在2021年的IEDM上,imec展示了一种完全300mm BEOL兼容的基于igzo的无电容DRAM电池,并改进了规格,即>103秒保留和无限(>1011)续行能力。这些结果是通过对单个IGZO晶体管选择最优的集成方案,即埋氧隧道和自对齐接触的栅极-最后集成方案得到的。实验证明,在不影响源极和漏极区串联电阻的情况下,采用埋地氧隧道结合O2环境退火,可以降低IGZO通道中的氧空位浓度,从而获得更大的通流和更低的关流。
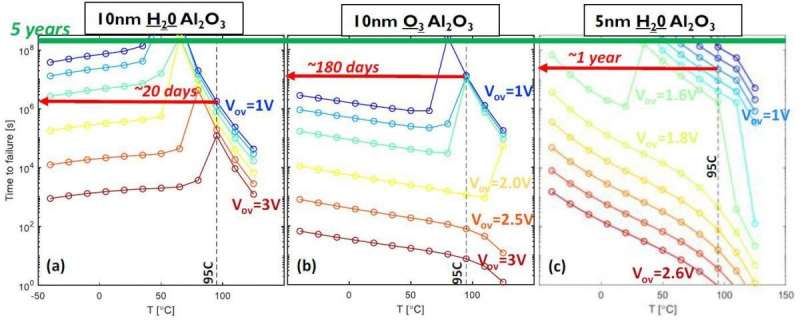 图2:IGZO薄膜的失效时间(12nm厚的非晶IGZO薄膜)based在不同的栅极介质上。栅极电介质优化实现了从一个
大约20天到一个
大约在运营公司工作一年
条件如图所示。最终目标是5年的失败时间(如2021年IEDM提出的)。信贷:IMEC
图2:IGZO薄膜的失效时间(12nm厚的非晶IGZO薄膜)based在不同的栅极介质上。栅极电介质优化实现了从一个
大约20天到一个
大约在运营公司工作一年
条件如图所示。最终目标是5年的失败时间(如2021年IEDM提出的)。信贷:IMEC
采用这种结构,IGZO TFT的栅极长度可以被缩减到前所未有的14nm,同时仍然保持>100秒的保留。通过等效氧化层厚度(EOT)缩放控制阈值电压(Vt),通过改善接触电阻和减小IGZO层厚度,可以进一步优化小栅长度的保留。当后者的厚度减少到5nm时,甚至可以省略O2中的氧隧道和退火步骤,从而得到一个非常简单的集成方法。
关于选择的集成方法和实现的器件规格的更多细节,请参见A. Belmonte等人于2021年发表的IEDM论文《为无电容DRAM定制IGZO-TFT架构,演示>103s保持、>1011循环耐久性和Lg可扩展至14nm》。
一生估计英航基于PBTI的可靠性建模方法
到目前为止,由于IGZO TFT的退化机制尚未被完全理解,因此缺乏一个准确的模型来预测基于IGZO的DRAM的寿命。IGZO晶体管本质上是n型器件,这表明正偏置温度不稳定性(PBTI)可能是主要的退化机制。
PBTI是Si - n型金属氧化物-半导体场效应晶体管(mosfet)中一种众所周知的老化机制,它会严重影响器件的性能和可靠性。它通常表现为器件阈值电压的不期望的偏移和漏极电流的减小。对于这些硅基器件,PBTI归因于栅极介质中电子陷阱的存在,使电荷载流子从器件的导通通道中被捕获。
现有的IGZO薄膜晶体管可靠性评估大多忽略了栅极介质的影响。Imec首次研究了栅极介质对IGZO薄膜晶体管PBTI的影响。这些结果被A. Chasin等人在2021年IEDM论文《理解和建模薄膜IGZO晶体管的PBTI可靠性》中总结。
研究小组发现有四种不同的机制在降解过程中起作用,每种机制都有不同的时间动力学和活化能。这主要归因于栅极介质中电子的俘获,以及在PBTI胁迫下栅极介质中氢元素释放到IGZO通道。
imec团队将这些多种降解机制组合成一个模型,这使得预测IGZO TFT在目标运行条件下的寿命成为可能。该模型符合实验数据,可用于提出提高寿命的优化方案。例如,通过降低栅极介质厚度,预测的失效时间可以从大约20天提高到大约一年。
基于igzo的DRAM单元结构和集成的改进使2T0C DRAM单元具有>103的保留,无限的持久性和栅极长度缩小到14nm。这些规格使无电容IGZO-DRAM成为实现高密度3D DRAM内存的合适人选。器件改进还补充了IGZO TFT可靠性的新见解,揭示了PBTI的不同降解机制。这些构成了一个精确模型的关键成分,利用该模型可以预测DRAM内存的关键组件的寿命。






